自动清洗设备,烘箱,热板,匀胶机,显影机,光刻机,刻蚀机(icp drie等),vHF,氧化炉,磁控溅射,电子束蒸发,退火炉,MOCVD,MBE等等,可以看《半导体制造技术》
半导体专用设备泛指用于生产各类半导体产品所需的生产设备,属于半导体行业产业链的关键支撑环节。
半导体专用设备是半导体产业的技术先导者,芯片设计、晶圆制造和封装测试等需在设备技术允许的范围内设计和制造,设备的技术进步又反过来推动半导体产业的发展。
以半导体产业链中技术难度最高、附加值最大、工艺最为复杂的集成电路为例,应用于集成电路领域的设备通常可分为前道工艺设备(晶圆制造)和后道工艺设备(封装测试)两大类。其中的前道晶圆制造中有七大步骤,如下图所示:

半导体设备主要应用在半导体产业链中的晶圆制造和封装测试环节。硅片制造是半导体制造的第一大环节,硅片制造主要通过硅料提纯、拉晶、整型、切片、研磨、刻蚀、抛光、清洗等工艺将硅料制造成硅片,然后提供给晶圆加工厂。

半导体工业中有两种常用方法生产单晶硅,即直拉单晶制造法(CZ 法)和悬浮区熔法(FZ 法)。CZ 法是硅片制造常用的方法,它较 FZ 法有较多优点,例如只有 CZ 法能够做出直径大于 200mm 的晶圆,并且它的价格较为便宜。
CZ 法的原理是将多晶硅硅料置于坩埚中,使用射频或电阻加热线圈加热熔化,待温度超过硅的熔点温度后,将籽晶浸入、熔接、引晶、放肩、转肩等径等步骤,完成一根单晶硅棒的拉制。

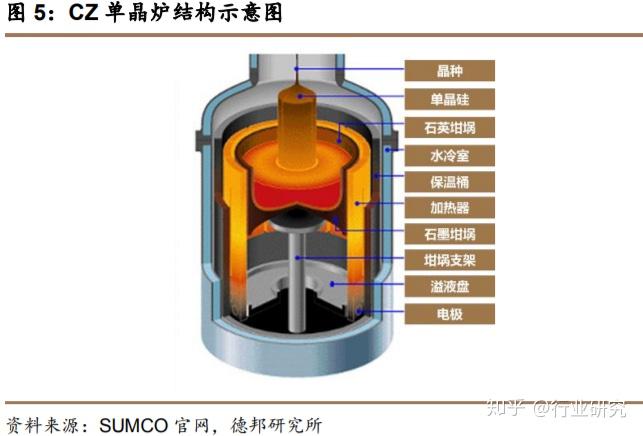

单晶生长炉是生产单晶硅的主要半导体设备。

单晶硅棒完成后,还需要经过一系列加工才能得到硅片成品,主要涉及的半导体设备有切片机、研磨机、湿法刻蚀机、清洗机、抛光机和量测机。

晶圆制造是半导体制造过程中最重要也是最复杂的环节,整个晶圆制造过程包括数百道工艺流程,涉及数十种半导体设备。晶圆制造主要的工艺流程包括热处理、光刻、刻蚀、离子注入、薄膜沉积、化学机械研磨和清洗。
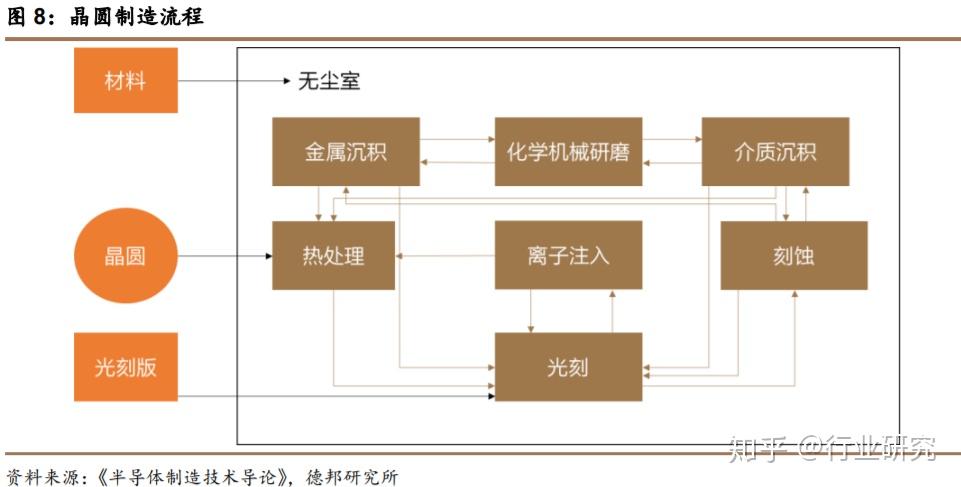
热处理主要包括氧化、扩散和退火工艺。氧化是一种添加工艺,是将硅片放入高温炉中,加入氧气与之反应,在晶圆表面形成二氧化硅。扩散是通过分子热运动使物质由高浓度区移向低浓度区,利用扩散工艺可以在硅衬底中掺杂特定的掺杂物,从而改变半导体的导电率,但与离子注入相比扩散掺杂不能独立控制掺杂物浓度和结深,因此现在应用越来越少。
退火是一种加热过程,通过加热使晶圆产生特定的物理和化学变化,并在晶圆表面增加或移除少量物质。

热处理工艺使用的半导体设备为氧化扩散设备,其实质为高温炉。高温炉分为直立式和水平式高温炉,高温炉主要包括五个基本组件:控制系统、工艺炉管、气体输送系统、气体排放系统和装载系统。高温炉必须具有稳定性、均匀性、精确的温度控制、低微粒污染、高生产率和可靠性。
登录“行行查”网站获取更多的行业研究数据
光刻工艺流程中最核心的半导体设备是光刻机,光刻机是半导体设备中技术壁垒最高的设备,其研发难度大,价值量占晶圆制造设备中的 30%。
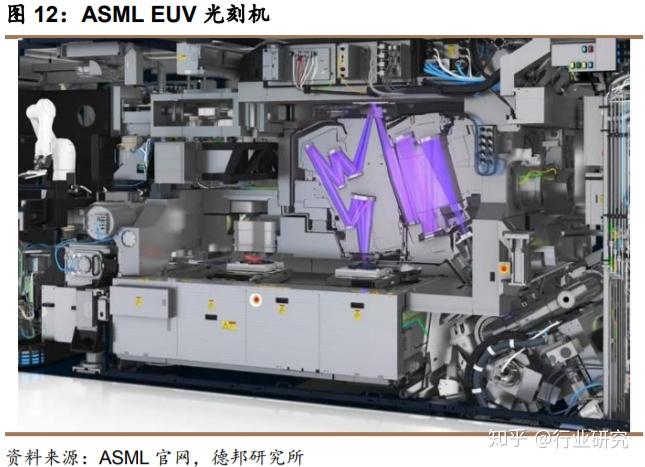
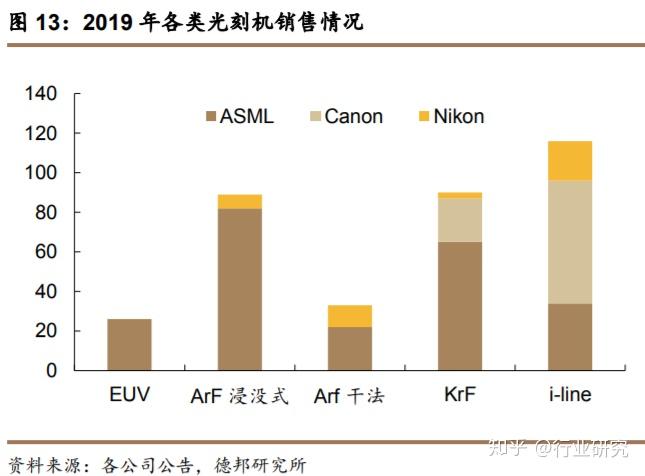
光刻工序所使用的半导体设备除了核心设备光刻机外,还需要涂胶显影设备。涂胶显影设备是光刻工序中与光刻机配套使用的涂胶、烘烤及显影设备,包括涂胶机、喷胶机和显影机,在 8 英寸及以上晶圆的大型生产线上,此类设备一般都与光刻设备联机作业,组成配套的圆片处理与光刻生产线,与光刻机配合完成精细的光刻工艺流程。

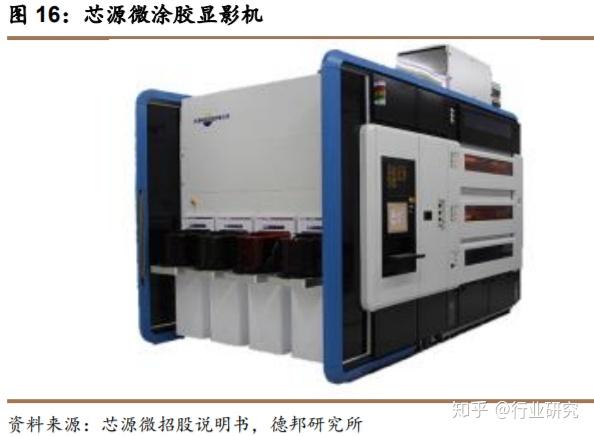
刻蚀工艺使用的半导体设备为刻蚀机。


离子注入所使用的半导体设备为离子注入机,离子注入机是非常庞大的设备,包括了气体系统、电机系统、真空系统、控制系统和最重要的射线系统。根据离子束电流和束流能量范围,一般可以把离子注入机分为低能大束流离子注入机、高能离子注入机和中低束离子注入机。
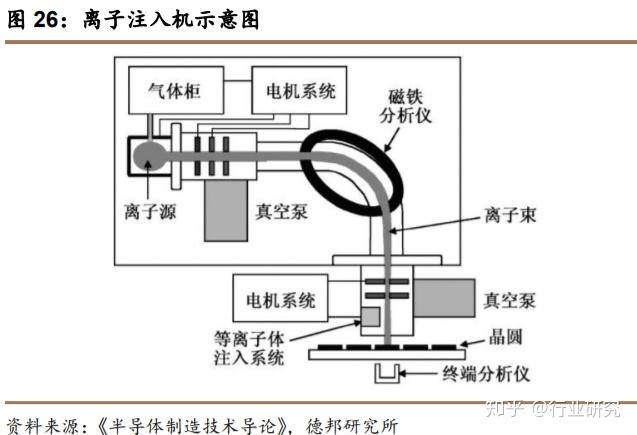

CVD 工艺使用的半导体设备是化学气相沉积设备,全球的化学气相沉积设备市场主要由应用材料、泛林半导体和东京电子所垄断,CR3 为 70%。
从 CVD 设备种类来看,PECVD、APCVD 和 LPCVD 三类 CVD 设备合计市场份额约占总市场份额的 70%,仍旧是 CVD 设备市场的主流。


目前 ALD 设备尚未在集成电路行业中大规模使用,应用材料、泛林半导体和东京电子都已经推出了 ALD 设备,国内设备生产商在 ALD 设备方面也有布局。

PVD 工艺使用的半导体设备为 PVD 设备,全球 PVD 设备市场基本上为应用材料所垄断,其市场份额高达 85%,其次为 Evatec 和 Ulvac,市场份额分别为 6%和 5%。
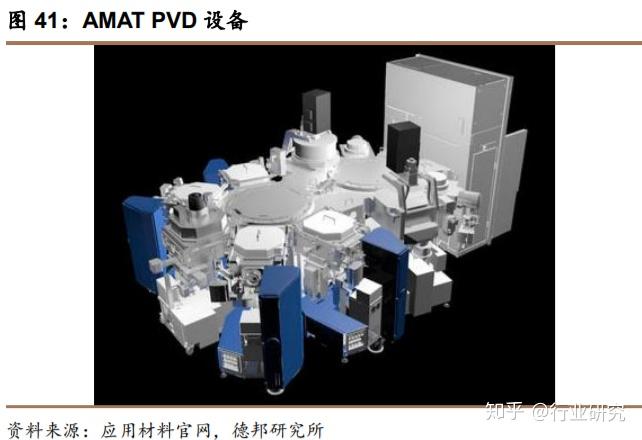

CMP 工艺使用的半导体设备是化学机械研磨机。常见的 CMP 系统包括研磨衬垫、可以握住晶圆并使其表面向下接触研磨衬垫的自旋晶圆载具,以及一个研磨浆输配器装置。
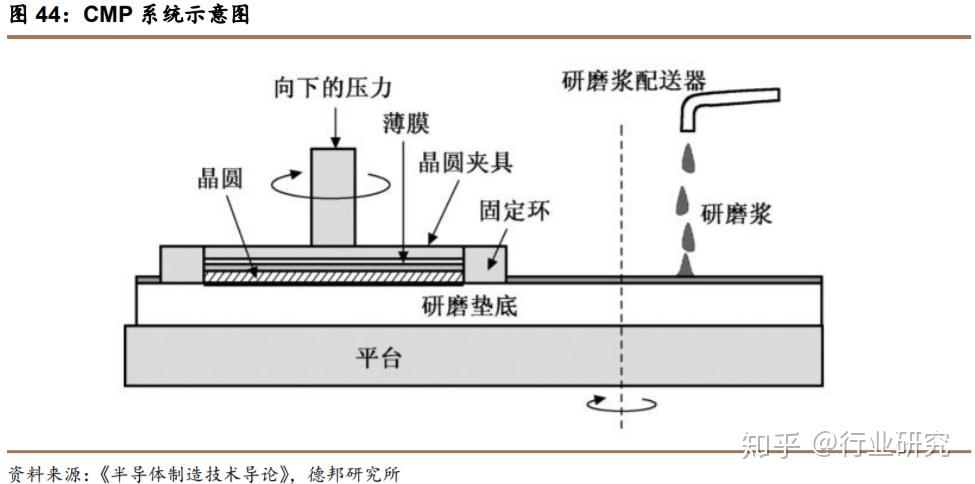
在全球清洗设备市场,市场集中度较高。国内的清洗设备领域主要有盛美半导体、北方华创、芯源微、至纯科技。

测试设备通过探针台和分选机将设备与芯片链接,通过施加激励信号并收集反馈,测试芯片的电流、电压等主要参数,判断芯片在不同工作环境下的性能有效性是否达到设计要求。1)设计检测是对晶圆样品和集成电路封装样品进行有效性验证;2)CP 检测是在晶圆制造环节提早发现失效产品;3)FT 检测是芯片产品投入市场之前最后的把关环节。
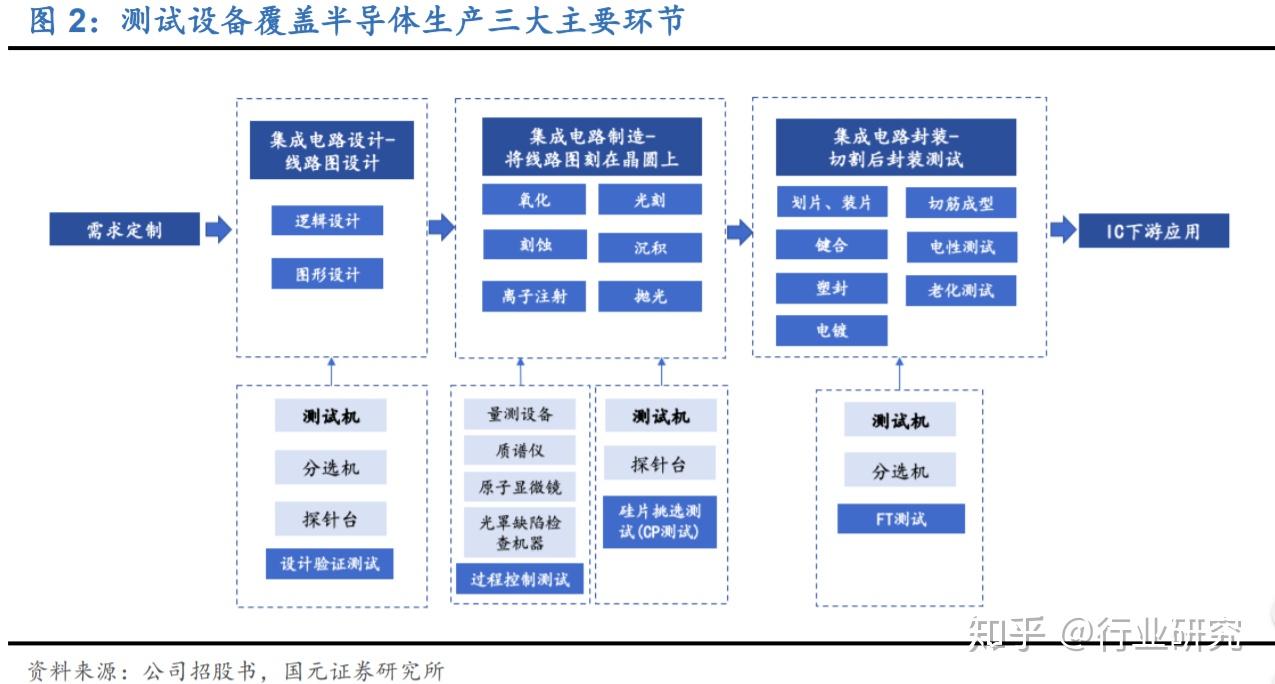
ATE 设备应用最多的是后道封测环节,我国半导体封测产能和技术方面均处于全球领先地位。半导体探针台设备行业集中度较高。

分选机按照系统结构可以分为三大类别,即重力式分选机、转塔式分选机、平移拾取和放置式分选机。全球分选机市场由爱德万、科休、爱普生三家企业所垄断,国内的分选机生产商主要有长川科技。
根据 SEMI 数据,预计 2021 年全球半导体专用设备市场规模突破 700 亿美元,中国半导体设备市场规模达 164 亿美元,同比增速保持 10%以上。Gartner 数据统计,测试类设备占半导体设备总市场的 8-9%,推算 2020 年全球测试设备市场规模约 55 亿美元。


半导体测试设备主要可分为测试机、探针台和分选机三大类,其中测试机占比约65%。根据赛迪咨询数据,2018 年我国半导体测试机按应用领域划分,存储类占比43.8%,SoC 类占比 23.5%,其余还包括数字、模拟和分类器件等。
测试类设备占半导体设备总市场的 8-9%,推算 2020 年中国大陆测试设备市场规模约 80 亿人民币,其中测试机市场约 50 亿元。


全球半导体后道测试市场被海外龙头高度垄断,前三企业合计市场占比达 98%。国际龙头厂商在技术和市场占有率均处于绝对领先地位,产品布局集中在 SoC 和存储器测试领域。


封装是将芯片在基板上布局、固定及连接,并用可塑性绝缘介质灌封形成电子产品的过程,目的是保护芯片免受损伤,保证芯片的散热性能,以及实现电能和电信号的传输,确保系统正常工作。封装设备主要有切割减薄设备、引线机、键合机、分选测试机等。
半导体设备位于产业链的上游,其市场规模随着下游半导体的技术发展和市场需求而波动。2013-2018 年,在智能手机和消费电子快速发展的推动下,半导体设备进入了一个持续上升的行业周期,市场规模从 317.9亿美元增长到了 645.3 亿美元,5 年 GACR 为 15%。而 2019 年全球半导体设备支出为 597.5 亿美元,同比下降7.4%,增长势头稍有回落。
根据 SEMI 预测,2020 年全球半导体设备市场规模达创纪录的 689 亿美元,同比增长 16%,2021 年将达 719 亿美元,同比增长 4.4%,2022 年仍旧保持增长态势,市场将达 761 亿美元,同比增长 5.8%。

随着 PC 和消费电子在国内的市场不断扩大,对于集成电路的旺盛需求带来了国内对于集成电路产业的持续投资。自 2013 年以来国内的半导体设备市场规模不断增长,2013 年国内半导体设备市场规模 33.7 亿美元,根据 SEMI 预测,2020 年市场规模预计达 181 亿美元,七年 CAGR 达 27%。在 2019 年全球半导体资本支出低迷的情况下,国内半导体设备支出仍旧保持了增长态势,市场规模达 134.5亿美元。同比增长 2.5%。
在国家政策和资金支持下,2021 和 2022 年中国大陆的半导体设备支出将持续保持高位,市场规模将保持在 180 亿美元。2019 年国产半导体设备销售额为 161.82 亿元,同比增长 30%。其中集成电路设备销售额为 71.29 亿元,同比增长 55.5%。而中国大陆 2019 年半导体设备市场规模 134.5 亿美元,国产化率约 17%,具备较大国产替代空间。


当前我国半导体设备依旧高度依赖于海外企业,并且在核心技术和零部件上受到一定的限制。半导体设备涉及数学、物理、化学、光学、力学等多个基础学科,技术壁垒高,研发难度大周期长,是整个产业中最关键的环节之一。
半导体设备直接关系芯片设计能否落成实物,产品可靠性和良率能否达到设计标准,国内行业是否能够参与全球竞争。因此要实现我国半导体产业链的自主可控,半导体设备至关重要。
扫描下图二维码了解行业图鉴1.0

手机访问“行行查”小程序更方便
半导体主要有四个组成部分:集成电路、光电子器材、分立器材和传感器;集成电路是半导体工业的核心,占到了80%以上。集成电路包括逻辑芯片、存储芯片、模拟芯片和mpu等。集成电路在性能、集成度、速度等方面的快速发展是以半导体物理、半导体器件、半导体制造工艺的发展为基础的。
1、单晶炉设备功能:熔融半导体材料,拉单晶,为后续半导体器件制造,提供单晶体的半导体晶坯。
2、气相外延炉,设备功能:为气相外延生长提供特定的工艺环境,实现在单晶上,生长与单晶晶相具有对应关系的薄层晶体,为单晶沉底实现功能化做基础准备。气相外延即化学气相沉积的一种特殊工艺,其生长薄层的晶体结构是单晶衬底的延续,而且与衬底的晶向保持对应的关系。
3、分子束外延系统,设备功能:分子束外延系统,提供在沉底表面按特定生长薄膜的工艺设备;分子束外延工艺,是一种制备单晶薄膜的技术,它是在适当的衬底与合适的条件下,沿衬底材料晶轴方向逐层生长薄膜。
4、氧化炉(VDF),设备功能:为半导体材料进行氧化处理,提供要求的氧化氛围,实现半导体预期设计的氧化处理过程,是半导体加工过程的不可缺少的一个环节。
5、低压化学气相淀积系统(LPCVD),设备功能:把含有构成薄膜元素的气态反应剂或液态反应剂的蒸气及反应所需其它气体引入LPCVD设备的反应室,在衬底表面发生化学反应生成薄膜。
6、等离子体增强化学气相淀积系统(PECVD),设备功能:在沉积室利用辉光放电,使其电离后在衬底上进行化学反应,沉积半导体薄膜材料。
7、磁控溅射台(MSA),设备功能:通过二极溅射中一个平行于靶表面的封闭磁场,和靶表面上形成的正交电磁场,把二次电子束缚在靶表面特定区域,实现高离子密度和高能量的电离,把靶原子或分子高速率溅射沉积在基片上形成薄膜。
8、化学机械抛光机(CMP),设备功能:通过机械研磨和化学液体溶解“腐蚀”的综合作用,对被研磨体(半导体)进行研磨抛光
9、光刻机,设备功能:在半导体基材上(硅片)表面匀胶,将掩模版上的图形转移光刻胶上,把器件或电路结构临时“复制”到硅片上。
10、反应离子刻蚀系统(RIE),设备功能:平板电极间施加高频电压,产生数百微米厚的离子层,放入式样,离子高速撞击式样,实现化学反应刻蚀和物理撞击,实现半导体的加工成型。
11、ICP等离子体刻蚀系统,设备功能:一种或多种气体原子或分子混合于反应腔室中,在外部能量作用下(如射频、微波等)形成等离子体,一方面等离子体中的活性基团与待刻蚀表面材料发生化学反应,生成可挥发产物;另一方面等离子体中的离子在偏压的作用下被引导和加速,实现对待刻蚀表面进行定向的腐蚀和加速腐蚀。
12、湿法刻蚀与清洗机,设备功能:湿法刻蚀是将刻蚀材料浸泡在腐蚀液内进行腐蚀的技术。清洗是为减少沾污,因沾污会影响器件性能,导致可靠性问题,降低成品率,这就要求在每层的下一步工艺前或下一层前须进行彻底的清洗。
13、离子注入机(IBI),设备功能:对半导体表面附近区域进行掺杂。
14、探针测试台,设备功能:通过探针与半导体器件的pad接触,进行电学测试,检测半导体的性能指标是否符合设计性能要求。
15、晶片减薄机,设备功能:通过抛磨,把晶片厚度减薄。
16、晶圆划片机(DS),设备功能:把晶圆,切割成小片的Die。
17、引线键合机(Wire Bonder),设备功能:把半导体芯片上的Pad与管脚上的Pad,用导电金属线(金丝)链接起来。
芯片供应/采购信息,电子元器件型号、芯片规格书查询,行业资讯、企业查询,尽在icspec平台。
icspec-芯片求购信息、电子元器件型号查询
半导体设备:
半导体设备分为前道制造设备以及后道封测设备。其中,前道设备主要包括光刻设备、刻蚀设备、薄膜沉积设备、离子注入设备、清洗设备、机械抛光设备以及扩散设备。而后道测试设备主要包括分选机、测试机、划片机、贴片机等。从市场规模来看,前道晶圆制造设备的市场规模占整个设备市场规模的80%以上。

光刻机:
光刻是将设计好的电路图从掩膜版转印到晶圆表面的光刻胶上,通过曝光、显影将目标图形印刻到特定材料上的技术。光刻工艺包括三个核心流程:涂胶、对准和曝光以及光刻胶显影,整个过程涉及光刻机,涂胶显影机、量测设备以及清洗设备等多种核心设备,其中价值量最大且技术壁垒最高的部分就是光刻机。
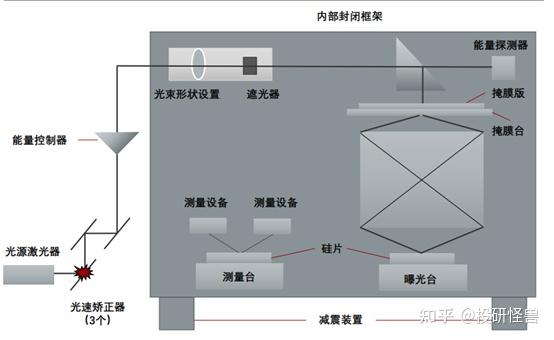
光刻机由光源波长进行区分可以分为可见光(g-line),紫外光(i-line),深紫外光(KrF、ArF)以及极紫外(EUV)几大类,当前最先进的3nm制程只能通过EUV光刻机才能实现。

光刻机竞争格局:
目前全球光刻机市场几乎由ASML、尼康和佳能三家厂商垄断,其中又以ASML一家独大。2021年ASML占比65%,出货量达到309台(全球总共约500台),力压尼康和佳能,其中EUV/ArFi/ArF高端光刻机占比分别为100%/95.3%/88%。EUV光刻机单价超过1亿欧元,全球仅有ASML可提供。

目前国内具备光刻机生产能力的企业主要是上海微电子装备有限公司,有SSX600和SSB500两个系列,其中SSX600系列主要应用于IC前道光刻工艺,可满足IC前道制造90nm、110nm、280nm关键层和非关键层的光刻工艺需求;SSB500系列光刻机主要应用于IC后道先进封装工艺。
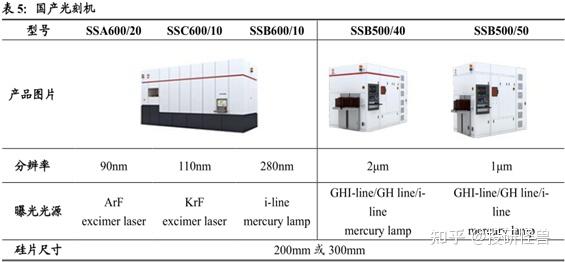
上海微电子与ASML在光刻机领域的差距客观反映中国和西方在精密制造领域差距,超高端光刻机关键零部件来自不同西方发达国家,来自美国光源,德国镜头和法国阀件等,所有核心零部件皆对中国禁运。
刻蚀设备:
刻蚀是用化学、物理、化学物理结合的方法有选择的去除(光刻胶)开口下方的材料。
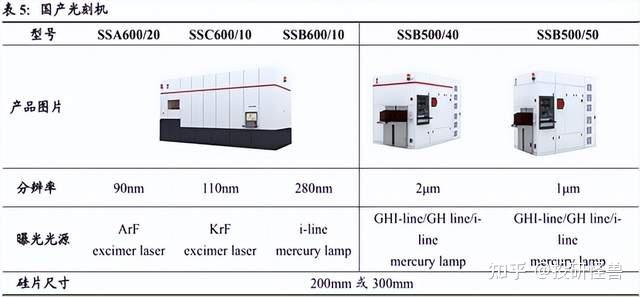
刻蚀设备按照刻刻蚀方式可以分为湿法刻蚀和干法刻蚀,但是湿法刻蚀由于刻蚀的精度较低,在制程不断微缩的情境下,逐渐被干法刻蚀取代,在部分制程要求不太精密的芯片上在使用湿法刻蚀。
刻蚀设备竞争格局:
刻蚀设备主要由美国泛林半导体、日本东京电子以及美国应用材料三家占据领先地位,2020年三家市场份额合计占比近9成。目前国内有中微公司和北方华创两家刻蚀设备供应商。

国内刻蚀龙头企业的部分技术已达到国际一流水平。在目前广泛使用的高密度等离子刻蚀设备上,中微公司的ICP和CCP刻蚀设备与泛林集团DRIE刻蚀设备的刻蚀效果相当。同时,中微公司的介质刻蚀已经进入台积电7nm/5nm产线,是唯一一家进入台积电产线的国产刻蚀设备生产商。北方华创在ICP刻蚀领域优势显著,已量产28nm制程以上的刻蚀设备,同时已经突破14nm技术,并进入中芯国际 14nm产线验证阶段。

截至2020年12月,长江存储共累计招标348台刻蚀设备,其中美国厂商Lam Research占据超过一半的采购量,达187台;而国内厂商中微公司、北方华创、屹唐股份分别中标50台、18 台、13台,国产化率高达23.85%。以华虹六厂设备招中标情况为例,截至2020年12月,华虹六厂共累计招标81台刻蚀设备,其中Lam Research依旧占据超过一半的采购量,达45台;国内厂商中微半导体、北方华创分别中标15 台、1台,国产化率约为19.75%。

薄膜沉积设备:
薄膜沉积技术用于制造微电子器件上的薄膜,主要是通过物理或化学方法,将适当化学反应源激活,并将由此形成的离子原子等吸附聚集在衬底表面,从而在衬底之上形成一层薄薄的膜,比如二氧化硅薄膜,多晶硅薄膜,金属薄膜等。这些薄膜辅助构成了制作集成电路的功能材料层。
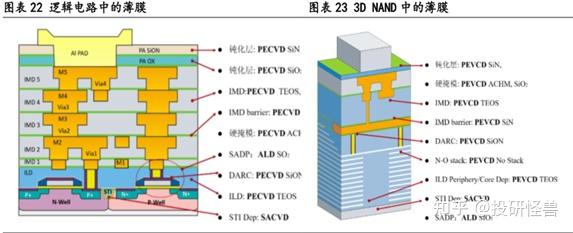
根据工作原理的不同,集成电路薄膜沉积可分为物理气相沉积(PVD)、化学气相沉积(CVD)和其他。薄膜沉积工艺不断发展,根据不同的应用演化出了PECVD、溅射PVD、ALD、LPCVD等不同的设备用于晶圆制造的不同工艺。
全球薄膜沉积设备中CVD类设备占比最高,2020年占比64%,溅射PVD设备占比 21%。CVD设备中,PECVD是主流的设备类型,2020年在CVD设备中占比 53%,其次为ALD设备,占比20%。

薄膜沉积设备竞争格局:
全球薄膜沉积设备市场由应用材料(AMAT)、泛林半导体(Lam Research)、东京电子(TEL)和先晶半导体(ASM)等国际巨头公司垄断。

国内从事CVD设备开发销售的公司主要有北方华创、中微公司和拓荆科技。北方华创主要研发PVD、LPCVD和APCVD设备,中微公司主要研发MOCVD设备。拓荆科技主要是PECVD ,ALD以及SACVD设备。
拓荆科技的产品已适配国内最先进的28/14nm逻辑芯片、19/17nm DRAM芯片和64/128层3D NAND FLASH晶圆制造产线,2.5D、3D先进封装及其他泛半导体领域。
拓荆科技 PECVD设备年产50台,其它设备平均年产2台。

薄膜沉积设备国产化率估计仅5.5%(按设备数量口径)。2020年1月1日以来国内部分主要晶圆制造产线的薄膜沉积设备招标情况,6家厂商共招标薄膜沉积设备1060台(仅PVD和CVD类设备),国内厂商中标58台,其中拓荆科技中标40台(主要为PECVD设备),国内市占率为3.8%;北方华创中标18台(主要为 PVD 设备),国内市占率1.7%。

薄膜沉积设备主要原材料依赖进口。
清洗设备:
清洗是晶圆加工制造过程中的重要一环,为了最大限度降低杂质对芯片良率的影响,硅片在进入每道工序之前表面必须是洁净的,需经过重复多次的清洗步骤,除去表面的污染物。
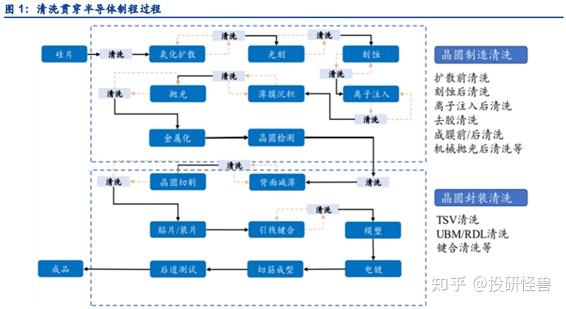

根据清洗的介质不同,清洗技术可以分为湿法清洗和干法清洗两种。晶圆制造产线上通常以湿法清洗为主,是目前市场上的主流清洗方法。
在湿法清洗的技术路线下,清洗设备可以分为单片清洗设备、槽式清洗设备、批式旋转喷淋清洗设备和洗刷器等。

从结构来看,单片清洗设备是目前市场的绝对主流,随着集成电路特征尺寸的进一步缩小,单片清洗设备在40nm以下的制程中的应用会更加广泛,未来的占比有望逐步上升。

清洗设备竞争格局:
全球半导体清洗设备行业的龙头企业主要是迪恩士(Dainippon Screen)、东京电子(TEL)、韩国SEMES、拉姆研究(Lam Research)等等。其中,迪恩士处于绝对领先地位,2020年占据了全球半导体清洗设备45.1%的市场份额,东京电子、SEMES和拉姆研究分别占据约25.3%、14.8%和12.5%。

国内的清洗设备领域主要有盛美半导体(年产40台)、北方华创、芯源微、至纯科技。其中,盛美半导体主要产品为集成电路领域的单片清洗设备和单片槽式组合清洗设备;北方华创收购美国半导体设备生产商Akrion Systems LLC之后主要产品为单片及槽式清洗设备;芯源微产品主要应用于集成电路制造领域的单片式刷洗领域;至纯科技具备生产8-12英寸高阶单晶圆湿法清洗设备和槽式湿法清洗设备的相关技术。
根据中国国际招标网信息,从2019 年~2021年H1中国主流晶圆厂清洗设备招标采购份额来看,我国半导体清洗设备的国产化率已经维持在10%~20%。

清洗设备上游原材料:
主要包括气路类、物料传送类、机械类、电气类等。

盛美上海原材料供应商风险:
Product Systems,Inc.为公司单片清洗设备中关键零部件兆声波发生器的唯一供应商;NINEBELL为公司单片清洗设备中传送系统中机器人手臂的主要供应商;Advanced Electric Co.,Inc.为公司单片清洗设备中阀门的关键供应商。
离子注入设备:
离子注入是通过对半导体材料表面进行某种元素的离子注入掺杂,从而改变其特性的掺杂工艺制程。通过离子注入机的加速和引导,将要掺杂的离子以离子束形式入射到材料中去,离子束与材料中的原子或分子发生一系列理化反应,入射离子逐渐损失能量,并引起材料表面成分结构和性能发生变化,最后停留在材料中,实现对材料表面性能的优化或改变。
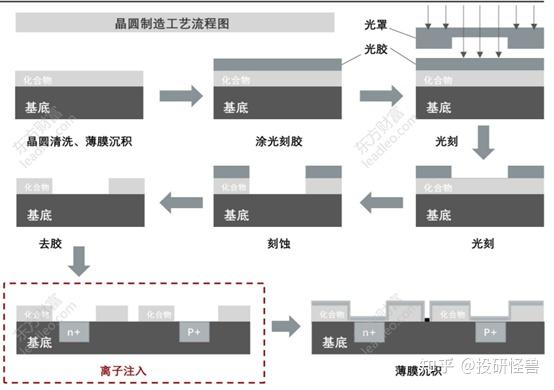
根据离子束电流和束流能量范围,离子注入机可分为三大类:中低束流离子注入机、低能大束流离子注入机、高能离子注入机。


离子注入机竞争格局:
美国应用材料公司、Axcelis占据全球大部分市场份额,其中美国应用材料公司在离子注入机产品上的市占率达到70%。

国内离子注入机也基本上被应用材料、Axcelis 和日本Sumitomo垄断,仅有万业企业旗下的凯世通、中科信(年产能30台)在某些12寸晶圆产线上获得工艺验证验证并验收通过。
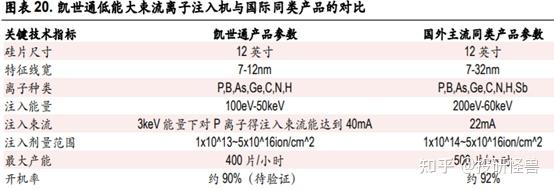
涂胶显影设备:
涂胶/显影机作为光刻机的输入(曝光前光刻胶涂覆)和输出(曝光后图形的显影),主要通过机械手使晶圆在各系统之间传输和处理,从而完成晶圆的光刻胶涂覆、固化、显影、坚膜等工艺过程。其直接影响到光刻工序细微曝光图案的形成,从而影响后续蚀刻和离子注入等工艺中图形转移的结果,因而涂胶显影设备是集成电路制造过程中不可或缺的关键处理设备。
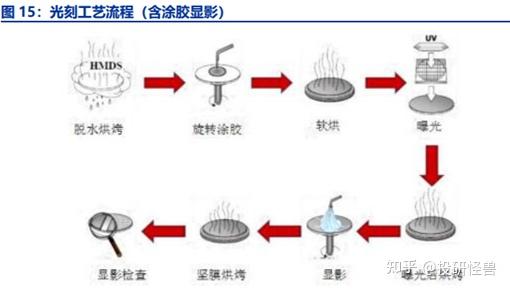
涂胶显影设备竞争格局:
2019年东京电子占据涂胶显影设备87%市场份额。国内市场来看,东京电子占据国内市场91%市场份额,DNS占据 5%市场份额,国内仅芯源微占据4%市场份额,国产替代空间十分广阔。

芯源微(21年产量219台)(28nm)为前道涂胶显影设备国内目前唯一供应商,持续技术升级,替代路径清晰。公司目前产品可覆盖 PI、Barc、SOC、SOD、I-line、KrF、ArF 等工艺,ArFi(浸没式 ArF)工艺设备也正在研发验证过程中。由于目前国内暂无EUV光刻设备,EUV工艺涂胶显影设备国内暂无需求。

去胶设备:
去胶即刻蚀或离子注入完成之后去除残余光刻胶的过程。去胶工艺类似于刻蚀,操作对象是光刻胶。去胶工艺可分为湿法去胶和干法去胶,湿法去胶工艺使用溶剂对光刻胶等进行溶解,干法去胶工艺可视为等离子刻蚀技术的延伸,主要通过等离子体和薄膜材料的化学反应完成,目前主流工艺是干法去胶。

去胶设备竞争格局:
全球干法去胶设备领域呈现多寡头竞争的发展趋势,前五大厂商的市场份额合计超过90%。屹唐半导体(20年产量153台)市占率位居全球第一,已全面覆盖全球前十大芯片制造商和国内行业领先芯片制造商,可用于90nm-5nm逻辑芯片、1y到2x纳米系列DRAM芯片以及32层到128层3D闪存芯片制造中若干关键步骤的大规模量产。

屹唐半导体风险:90%以上原材料依赖进口。
CMP抛光设备:
CMP技术即化学机械抛光,通过化学腐蚀与机械研磨的协同配合作用,实现晶圆表面多余材料的高效去除与全局纳米级平坦化。其工作过程是:抛光头将晶圆抵在粗糙的抛光垫上,借助抛光液腐蚀、微粒摩擦、抛光垫摩擦等耦合实现全局平坦化,抛光盘带动抛光垫旋转,通过先进的终点检测系统对不同材质和厚度的磨蹭实现3-10nm分辨率的实时厚度测量防止过抛。
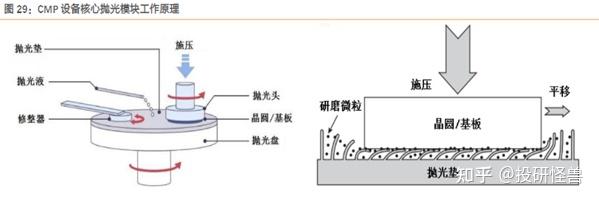
抛光设备竞争格局:
目前全球CMP设备市场处于高度集中状态,主要由美国应用材料和日本荏原两家设备制造商占据,合计拥有超过90%的市场份额。
国内CMP设备的主要研发生产单位有华海清科(28nm,21年12英寸产能87台,8英寸产能6台)和北京烁科精微电子装备有限公司,其中华海清科是国产12英寸和8英寸CMP设备的主要供应商,是目前国内唯一实现了12英寸CMP设备量产销售的半导体设备供应商,相较于国内其他厂商(如北京烁科精微)具有明显的行业领先地位。

检测设备:
半导体检测设备主要用于半导体制造过程中检测芯片性能与缺陷,几乎每一步主要工艺完成后都需要在整个生产过程中进行实时的监测,以确保产品质量的可控性,贯穿于半导体生产过程中,对保证产品质量起到关键性的作用。
广义上根据测试环节分为前道测试和后道测试设备。
前道量检测包括量测类和缺陷检测类,主要用于晶圆加工环节,目的是检查每一步制造工艺后晶圆产品的加工参数是否达到设计的要求或者存在影响良率的缺陷,属于物理性检测。
后道测试设备用于晶圆加工前的设计验证环节和晶圆加工后的封测环节,通过测试机和分选机或探针台配合使用,分析测试数据,确定具体失效原因,并改进设计及生产、封测工艺,以提高良率及产品质量,属于电性能的检测。

前道检测设备:
前道量测设备进一步细分为量测设备、缺陷检测设备以及过程控制软件,其中缺陷检测设备约占前道检测设备的55%,量测设备占前道量测设备的34%,过程控制软件占11%。进一步按产品细分,膜厚测量占比12%、OCD-SEM测量占比 10%,CD-SEM占比 11%、套刻误差测量占比9%;缺陷检测中有图形晶圆检测占比32%、无图形晶圆检测占比5%、电子束检测占比12%、宏观缺陷检测占比6%。

量测类设备:主要用来测量透明薄膜厚度、不透明薄膜厚度、膜应力、掺杂浓度、关键尺寸、套准精度等指标,以保证工艺的关键物理参数满足工艺指标,对应的设备分为椭偏仪、四探针、原子力显微镜、CD-SEM、OCD-SEM、薄膜量测等。

缺陷检测类设备:用来检测晶圆表面的缺陷,并获取缺陷的位置坐标(X,Y);分为明/暗场光学图形图片缺陷检测设备、无图形表面检测设备、宏观缺陷检测设备等。

前道检测设备竞争格局:
前道检测设备领域,科磊独占52%的份额,应用材料、日立高新则分别占比12%、11%,CR3合计占比接近80%,市场集中度较高,且基本被海外公司所垄断,国内企业市场份额不足1%。其中科磊在晶圆形貌检测、无图形晶圆检测、有图形晶圆检测领域市占率分别达到 85%、78%、72%,应用材料产品则主要为掩模版测量及电子束检测,日立高新则在 CD-SEM 领域市占率较高。

国内布局该领域的公司分别有上海睿励、上海精测和中科飞测。目前,上海睿励的薄膜测量设备成功进入三星和长江存储生产线;中科飞测的晶圆表面颗粒检测机成功进入中芯国际生产线,智能视觉检测系统成功进入长江存储生产线,椭偏膜厚量测仪进入士兰微生产线;上海精测(22年1-9月检测设备产量295台)的膜厚测量设备已经成功小批量生产并进入长江存储生产线,OCD量测设备已取得订单并已实现交付,首台半导体电子束检测设备eViewTM全自动晶圆缺陷复查设备已正式交付国内客户。
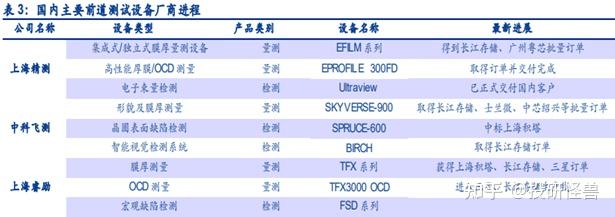
精测电子检测设备:

后道测试设备:
集成电路(后道)测试核心设备包括测试机、分选机、探针台3种,测试机负责检测性能,后两者主要实现被测晶圆/芯片与测试机功能模块的连接。

从结构来看,测试设备中,测试机在CP、FT两个环节皆有应用,而分选机和探针台分辨仅在设计验证和成品测试环节及晶圆检测环节与测试机配合使用,且测试机研发难度大、单机价值量更高,因此测试机占比最大,达到接近70%的比例,而分选机、探针台占比分别为17%、15%。

测试机:
按照测试机所测试的芯片种类不同,测试机可以分为模拟/混合类测试机、SoC测试机、存储器测试机等。模拟类测试机主要针对以模拟信号电路为主、数字信号为辅的半导体而设计的自动测试系统;SoC测试机主要针对SoC芯片即系统级芯片设计的测试系统;存储测试机主要针对存储器进行测试,一般通过写入一些数据之后在进行读回、校验进行测试。其中,SoC与存储测试机难度最高,同时在结构占比上也是测试机中占比最大的部分,在全球和国内市场均在70%左右占比。

分选机:
主要用于芯片的测试接触、拣选和传送等。分选机把待测芯片逐个自动传送至测试工位,通过测试机测试后分选机根据测试结果进行标记、编带和分选。
按照形态和适用情形分为重力式、平移式、转塔式、测编一体机。重力式结构简单,投资小;平移式适用范围广、测试时间较长或先进封装情况下优势明显;转塔式适合体积小、重量小、测试时间短的芯片。
就分选机产品结构而言,平移式和转塔式占比最高,转塔式主要测编一体机,技术壁垒较高,应用更加便捷,随着技术持续发展成本下降后占比有望持续提升。
探针台:
主要负则晶圆输送及定位,使晶圆依次与探针接触完成测试,提供晶圆自动上下片、找中心、对准、定位及按照设臵的步距移动晶圆以使探针卡上的探针能对准硅片相应位臵进行测试,按不同功能可以分为高温探针台、低温探针台、RF 探针台、LCD探针台等。
后道测试设备竞争格局:
测试机竞争格局:
自动测试系统(ATE)是半导体后道测试设备中的核心设备,全球半导体ATE市场主要由科休、爱德万和泰瑞达三大巨头占据,合计占比95%,市场集中程度较高。国内半导体测试机市场中,爱德万、泰瑞达和科休同样占据了近84%的市场,国内厂商华峰测控(21年产量1975台)和长川科技的市占率分别为8%和5%。

在国内模拟测试机市场,相关国内企业已经建立一定优势,据统计测算,2020年华峰测控/长川科技在国内模拟测试机占比为49.88%/24.08%,合计突破70%的市场份额。存储和soc设备正在突破中。

分选机竞争格局:
分选机主要市场由海外占领,但竞争格局较为分散,主要企业仍为科休、爱德万、台湾鸿劲以及长川科技,根据VLSI Research及Semi,科休占比最高为21%,Xcerra(已被科休收购)占比16%,国内企业长川科技占比2%。

从中国封测龙头长电科技和华天科技2016-2021年的招标结果来看,中国分选机市场国产化率很高,包揽市场份额3/4的前五家中仅有鸿劲科技来自中国台湾,其余四家皆为大陆厂商,长川科技位居榜首,整体国产化水平达65%。

探针台竞争格局:
探针台全球市场主要由两家龙头企业垄断,ACCRETECH占比46%,TEL占比27%,其余的企业为台湾旺矽、台湾惠特以及深圳矽电等。

深圳矽电是境内产品覆盖最广的晶圆探针台(21年产量3701台)设备厂商,产品类型从手动探针台到全自动探针台,尺寸从4英寸到12英寸,应用领域包括集成电路及分立器件的晶圆测试,步进精度可达到±1.3μm。公司晶粒探针台(21年产量1113台)已达到国际同类设备水平,适用于4-6英寸PD、APD、LED等光电芯片的自动测试,具有无损清针、滤光片自动切换等自主研发的技术。


封装设备:
传统封装设备按工艺流程主要分为晶圆减薄机、划片机、贴片机、引线键合机、塑封机及切筋成型机。

晶圆减薄机:
直径150mm(6寸)和200mm(8寸)的晶圆厚度分别为625um和725um,而直径为300mm硅片平均厚度达到775um。在晶圆中总厚度90%以上的衬底材料是为了保证晶圆在制造,测试和运送过程中有足够的强度。晶圆减薄工艺的作用是对已完成功能的晶圆(主要是硅晶片)的背面基体材料进行磨削,去掉一定厚度的材料。有利于后续封装工艺的要求以及芯片的物理强度,散热性和尺寸要求。
工作原理:通过空气静压主轴带动金刚石磨轮高速旋转,以IN-Feed或CREEP的方式对磨削材料进行物理去除。

晶圆减薄机竞争格局:
国外以日本DISCO、东京精密株式会社和以色列ADT公司(已被光力科技旗下的先进微电子有限公司收购)为主。

北京中电科电子装备有限公司成功推出了自主研发的8/12英寸全自动晶圆减薄机的产业化机型,目前已有20多台不同型号设备被用于集成电路材料加工、芯片制造、先进封装等工艺段的产品量产,产品良率和生产效率均达到日本进口同类机型水平。在第三代半导体材料加工领域,顺利完成SiC材料减薄工艺验证并形成多台设备订单。预计2022年减薄设备将实现合同额1.2亿元人民币,2023年全系列产品产值将突破2亿元人民币。
划片机:
划片机是使用刀片或者通过激光等方式高精度地切割硅片、玻璃、陶瓷等被加工物的装置,是半导体后道封测中晶圆切割和WLP切割环节的关键设备。目前刀片切割仍占据80%的市场份额,激光切割仅占据20%,预计刀片切割工艺在较长一段时期内仍将为主流切割方式。
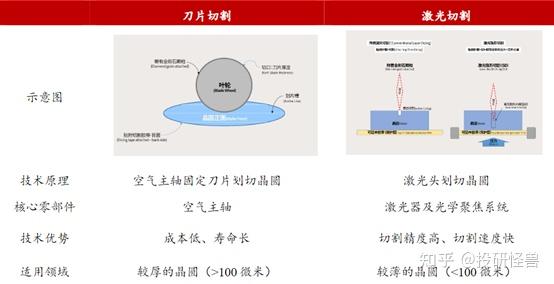
目前全球的划片机市场日本公司垄断90%以上,其中,Disco约占据70%市场份额,东京精密次之,划片机国产化率极低,只有5%左右。全球第三大划片机厂商以色列ADT已被国内光力科技收购,其在国内市场份额不足5%。
光力于2017年收购了英国的LPB公司70%股权,于2020 年进一步收购了LPB公司30%股权。是行业内仅有的两家(另一家为全球半导体划片机龙头企业DISCO)既有切割划片机设备,又有核心零部件——高精密气浮主轴的公司,综合竞争优势突出。
光力科技21年划片机产能300台,空气主轴产能1000根。
空气主轴广泛应用于半导体、汽车自动喷漆、接触式光镜片加工、高速鼓风机等领域。在半导体领域为切、磨、削设备中的核心部件,前道制造用的CMP平坦化设备、后道封装用的背面减薄机、研磨机的核心零部件均为空气主轴。公司在空气主轴领域技术领先,将以此为轴打造平台型公司,推出更多半导体高端装备系列产品,打开更广阔的成长空间。


固晶机:
固晶机又称为贴片机,主要应用于半导体封装测试阶段的芯片贴装环节,即将芯片从已经切割好的晶圆上抓取下来,并安置在基板对应的上,利用银胶把芯片和基板粘接起来。
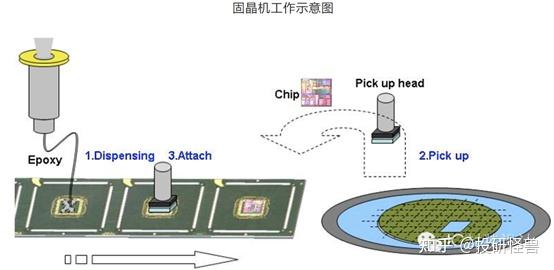
固晶机贴片内容主要分为几类:IC、传感器、分立器件、光通信模块、功率器件、LED。
IC成本较高,因此对贴片精度要求较高,封测厂在IC贴片环节通常将贴片速度调整至其最高速度的70%-80%来保障良率,所以直驱固晶机在IC贴片中有一定的优势。传感器、分立器件、光通信模块、功率器件和LED器件相对较大,对精度的要求便低了很多,同时由于其成本低,对次品率有一定的容忍度,再叠加其量大、以传统封装为主的特点,其对效率这一指标更为敏感,因此摆臂固晶机更具优势。



根据高工产业研究院2020最新数据,新益昌(20年总产量3000台)在中国固晶机市场的市占率超70%,客户普及率超过9成;根据Yole,2018年全球固晶设备(应用领域包括LED、半导体、光电子等)中新益昌的整体市场占有率为6%,在全球固晶设备市场排名第三,在LED 固晶机全球市场份额为28%。

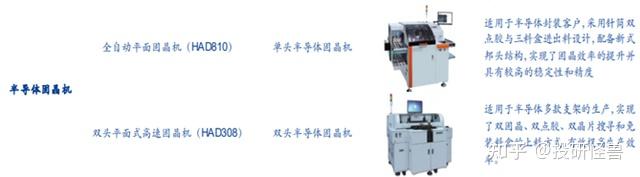
新益昌零部件自制率逐年提高,公司驱动器、导轨、电机、运动控制卡、高精度读数头及电磁阀于2020年的自产率分别为69.48%、15.30%、21.39%、24.17%、87.40%及11.08%,镜头全部外购,前五大供应商均为国内公司。
新益昌自产驱动器、电机、导轨、读头器的关键参数均优于外购。如XY平台驱动器在定位精度上,公司可以达到±3μm,优于Sanyo、Panasonic的设备±5μm;导轨方面,公司UW轴的使用时间超过12个月,高于SKF的6个月左右;电机方面,公司自产部件在精度和定位时间上都要好于外购的Panasonic产品。


引线键合(焊线)机:
焊线机用于引线键合工序,将金属引线与基板焊盘紧密焊合,目的是实现芯片的输入输出端与应用器件相连接,最终实现芯片与基板之间的电气互连和芯片间的信息互通。引线键合工艺中所用的导电丝主要有金丝、铜丝和铝丝。

按照焊接原理的不同,可分为热压键合、超声键合和热超声键合三种。热压键合和热超声键合的焊接材料为金线、铜线,而超声键合主要焊接材料为铝线。铝线键合机更适用于功率器件,金铜线键合机更多用于IC领域。

引线键合(焊线)机竞争格局:
目前国内市场被K&S、ASM Pacific垄断,2021年引线键合设备国产化率仅3%。2021年中国引线键合机进口量为31134台,国内铝线键合器一年的需求量大致在3600台左右。K&S(Kulicke & Soffa)是美国半导体封装设备龙头企业,核心提供焊线机及相关消耗性工具产品;ASM Pacific最早由荷兰ASMI出资设立,总部位于新加坡,其从单一的焊线机生产商成长为后道工序全产品供应商。
大陆企业新益昌、大族封测(21年产量3000台)、深圳翠涛布局焊线机。

国产焊线机公司:
大族封测:主流产品的核心性能与国际龙头企业基本持平


奥特维:铝丝键合机技术对标国外一线。
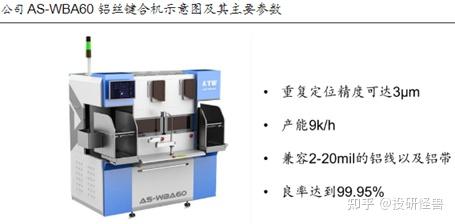
新益昌(收购深圳开玖):
开玖自动化的LED焊线机已在客户验证中,半导体焊线机预计将于2022H2推出样机。
主要有两大产品系列,包括小信号器件键合用金丝球焊线机(K900系列)和大功率半导体用粗铝丝压焊机(K530型、K550型),其中金丝球焊线机的代表机型K940型TO56焊线机在光通讯行业占有80%以上市场份额。

塑封机:
塑料封装是指将半导体集成电路芯片可靠地封装到一定的塑料外壳内。
芯片封装按技术路线不同,目前可分为金属封装、陶瓷封装和塑料封装,塑料封装凭借其优良的综合性能和高性价比,为目前半导体封装主流的封装技术,目前上述各种分类方法下的各芯片类型主要使用的是塑料封装。
塑封机竞争格局:
半导体全自动塑料封装设备呈现寡头垄断格局,TOWA、YAMADA 等公司占据了绝大部分的半导体全自动塑料封装设备市场。我国仅有少数国产半导体封装设备制造企业,拥有生产全自动封装设备多种机型的能力,文一科技、耐科装备与大华科技均是代表企业之一。
根据SEMI统计,2020年中国大陆半导体全自动塑料封装设备市场规模约为20亿元,其中TOWA每年销售量约为200台、YAMADA约为50台、BESI约50台、ASM约50台、文一科技及耐科装备每年各20台左右。
文一科技半导体设备中的关键元器件大部分依靠进口,这也使得国产设备的完全自主仍然面临挑战与风险。
耐科装备塑封设备:
目前可实现绝大部分塑料封装形式,目前尚无法实现树脂底部填充封装、采用压塑封装成型的晶圆级封装、板级封装等先进封装。

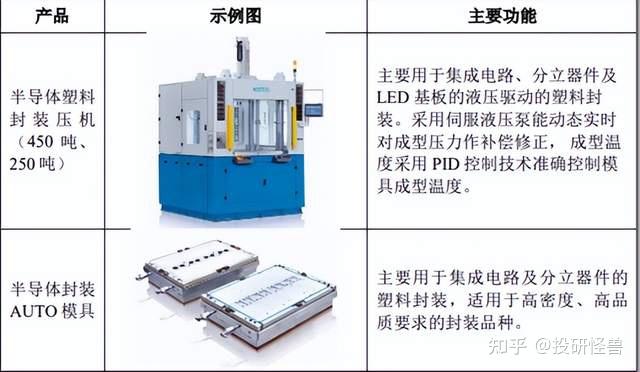
切筋成型设备:
切筋成型是将已完成封装的产品成型为满足设计要求的形状与尺寸,并从框架或基板上切筋、成型、分离成单个的具有设定功能的成品的过程。切筋成型产品在半导体封装中的作用如下:切除不需要的连接用材料,使引脚与引脚分离,实现电信号各自独立;成型符合设计要求的形状与尺寸,满足后续装配要求。
半导体切筋成型设备市场主要包含手动切筋成型设备和全自动切筋成型设备。目前,手动切筋成型设备已几乎全部淘汰,自动切筋成型设备是市场主流产品。
切筋成型设备竞争格局:
在全自动切筋成型设备领域主要企业有日本YAMADA、荷兰FICO、耐科装备、文一科技、东莞朗诚微电子设备有限公司、苏州均华精密机械有限公司、上海浦贝自动化科技有限公司、深圳市曜通科技有限公司、深圳尚明精密模具有限公司、深圳华龙精密有限责任公司等。
目前国产全自动切筋成型设备技术已基本达到大部分封测厂商的要求,产品处于相对成熟的发展阶段,国产设备市场处于自由竞争阶段,各国产品牌之间无特别明显的竞争优劣势,但在设备稳定性等方面相较于以日本YAMADA和荷兰FICO 为代表的全球知名品牌尚有一定的差距。
耐科装备切筋成型设备:

耐科装备原材料风险:
公司塑料挤出成型模具、挤出成型装置及下游设备使用的传感器、工控机、控制器、电磁阀等,公司半导体封装设备中使用的轴承、导轨、伺服电机、控制系统等零部件主要采购于日本品牌供应商(部分品牌在国内有生产工厂),公司也有国内供应商替代方案;公司半导体封装设备目前使用的 PM23钢、PM60钢主要采购于瑞典的模具钢材供应商,也可以从德国、日本采购,但无国内替代供应商,对该类原材料存在重大进口依赖。
半导体整个产业链,宏观看主要三类,设计、代工制造/芯片制造和封装测试。本篇只写芯片制造工艺和设备,后续会更新芯片制造材料,设计和封测等。由于是相关题材第一篇,所以会先全面介绍下,再聚焦到代工制造。

正式进入之前,建议看下面这篇科普,有点牛逼,不夸张地说,看完了可能就不想看我写的了,哈哈!
https://zhuanlan.zhihu.com/p/43626576不信的话先来个gif感受一下!
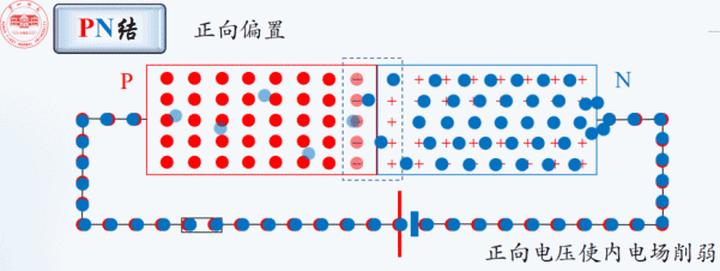
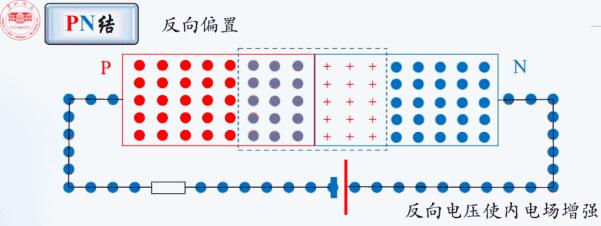
如果较真,这三个名词差别还挺大。如果是半导体行业内的人,再加上叙事语境,半导体一般指的是“半导体行业”,或者“芯片”,芯片就是指甲盖大小的那个物体,集成电路外观就是PCB板子的样子。不过,下面还是给出专业解释吧。
除了指半导体行业,还有半导体材料的意思。
半导体( semiconductor),指常温下导电性能介于导体(conductor)与绝缘体(insulator)之间的材料。如二极管就是采用半导体制作的器件。半导体是指一种导电性可受控制,范围可从绝缘体至导体之间的材料。
无论从科技或是经济发展的角度来看,半导体的重要性都是非常巨大的。今日大部分的电子产品,如计算机、移动电话或是数字录音机当中的核心单元都和半导体有着极为密切的关连。常见的半导体材料有硅、锗、砷化镓等,而硅更是各种半导体材料中,在商业应用上最具有影响力的一种。
物质存在的形式多种多样,固体、液体、气体、等离子体等。我们通常把导电性差的材料,如煤、人工晶体、琥珀、陶瓷等称为绝缘体。而把导电性比较好的金属如金、银、铜、铁、锡、铝等称为导体。可以简单的把介于导体和绝缘体之间的材料称为半导体。

芯片,又称微电路(microcircuit)、微芯片(microchip)、集成电路(integrated circuit, IC),是指内含集成电路的硅片,体积很小,常常是计算机或其他电子设备的一部分。
芯片(chip)就是半导体元件产品的统称,是集成电路(IC, integrated circuit)的载体,由晶圆分割而成。
硅片是一块很小的硅,内含集成电路,它是计算机或者其他电子设备的一部分。

集成电路(integrated circuit)是一种微型电子器件或部件。采用一定的工艺,把一个电路中所需的晶体管、电阻、电容和电感等元件及布线互连一起,制作在一小块或几小块半导体晶片或介质基片上,然后封装在一个管壳内,成为具有所需电路功能的微型结构;其中所有元件在结构上已组成一个整体,使电子元件向着微小型化、低功耗、智能化和高可靠性方面迈进了一大步。它在电路中用字母“IC”表示。
集成电路发明者为杰克·基尔比(基于锗(Ge)的集成电路)和罗伯特·诺伊思(基于硅(Si)的集成电路)。当今半导体工业大多数应用的是基于硅的集成电路。
集成电路是20世纪50年代后期一60年代发展起来的一种新型半导体器件。它是经过氧化、光刻、扩散、外延、蒸铝等半导体制造工艺,把构成具有一定功能的电路所需的半导体、电阻、电容等元件及它们之间的连接导线全部集成在一小块硅片上,然后焊接封装在一个管壳内的电子器件。其封装外壳有圆壳式、扁平式或双列直插式等多种形式。集成电路技术包括芯片制造技术与设计技术,主要体现在加工设备,加工工艺,封装测试,批量生产及设计创新的能力上。

第一代半导体材料主要是指硅(Si)、锗元素(Ge)半导体材料。第二代半导体材料主要是指化合物半导体材料,如砷化镓(GaAs)、锑化铟(InSb)第三代半导体材料主要以碳化硅(SiC)、氮化镓(GaN)、氧化锌(ZnO)为代表的宽禁带半导体材料。在应用方面,根据第三代半导体的发展情况,其主要应用为半导体照明、电力电子器件、激光器和探测器、

从沙子到芯片,3大过程,硅片/晶圆制造、芯片制造和封装测试。硅片/晶圆制造产品当然是硅片,样子像是一个光秃秃的光盘,芯片制造产品是一个个指甲盖大小的小方块,不是真正的芯片,封装就是把芯片集成的IC上面(跟一堆电容电阻集成在一起),才是真正的芯片。
芯片制造流程很长,加上过程中各种测试TTV、WARP和Thickness,几百个工序是有的。下面这个图给出主工艺流程,也可以很清楚表达出芯片的制造过程。
这可能最简单的半导体工艺流程(一文看懂芯片制作流程)_SiO2
举个例子,某厂从晶棒到硅片包装(硅片制造),主工序25个。
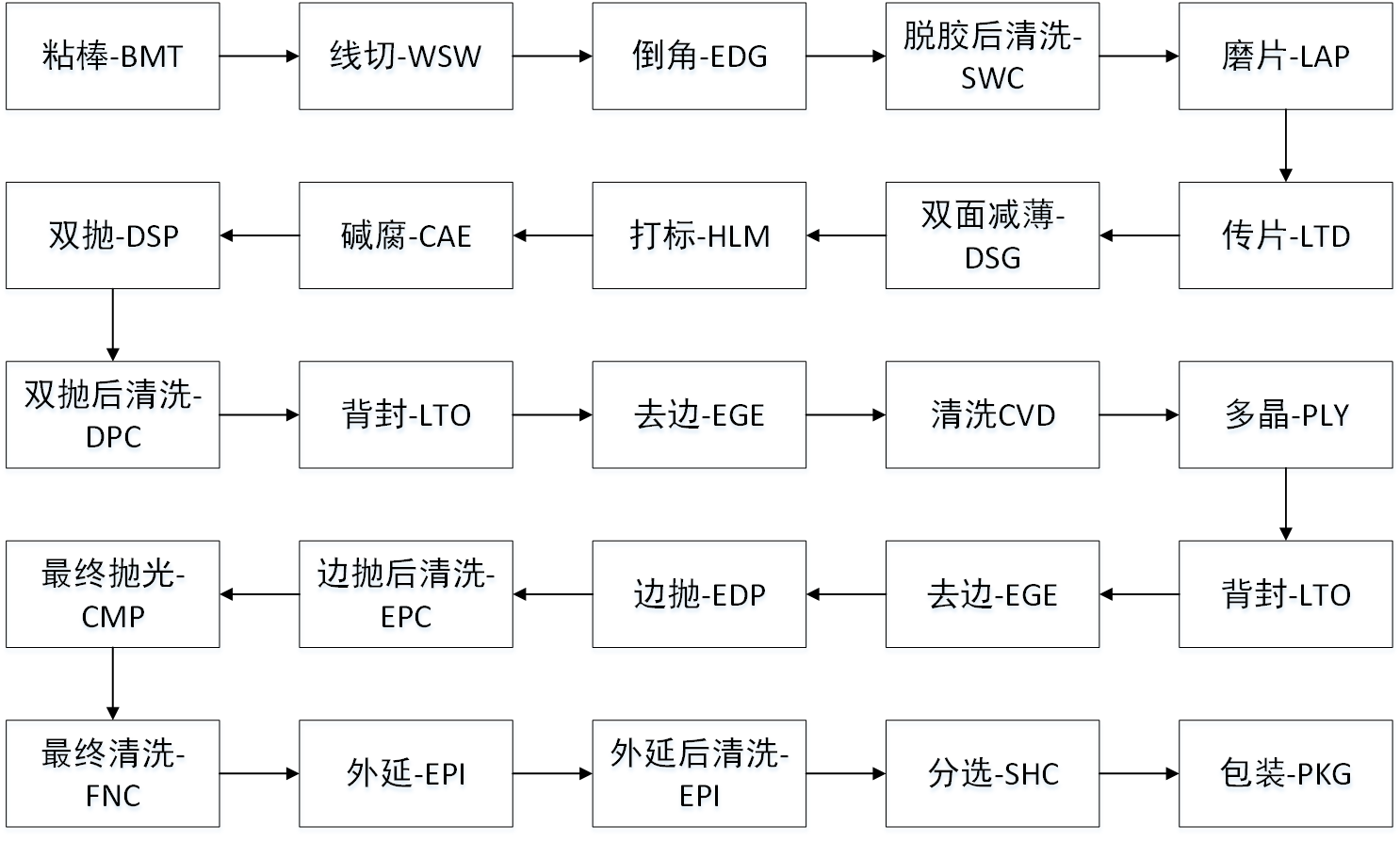
还是上几个视频吧,各有各的不同,各位兄弟关照几身取精华吧!你看完可能会懵,芯片制造到底几步啊,哈哈哈哈哈哈哈哈哈哈!先笑为敬!
 how-chips-are-manufacturedhttps://www.zhihu.com/video/1640123552077795328
how-chips-are-manufacturedhttps://www.zhihu.com/video/1640123552077795328最后再来一篇,这个也不错,他说是“八个步骤,数百个工艺”,妙啊!
揭秘芯片制造:八个步骤,数百个工艺这篇文章只写其中一个环节,半导体代工制造工艺流程和主要设备。
从上游往下游依次看过去,半导体产业链可以分为轻资产IC设计(也称为fabless厂)、重资产芯片制造、封装测试。

pp电子

代工制造/芯片制造也称半导体前道工序,制造工艺分为“三大”+“四小”工艺,三大是光刻、刻蚀、沉积,四小是离子注入、清洗、氧化、检测。
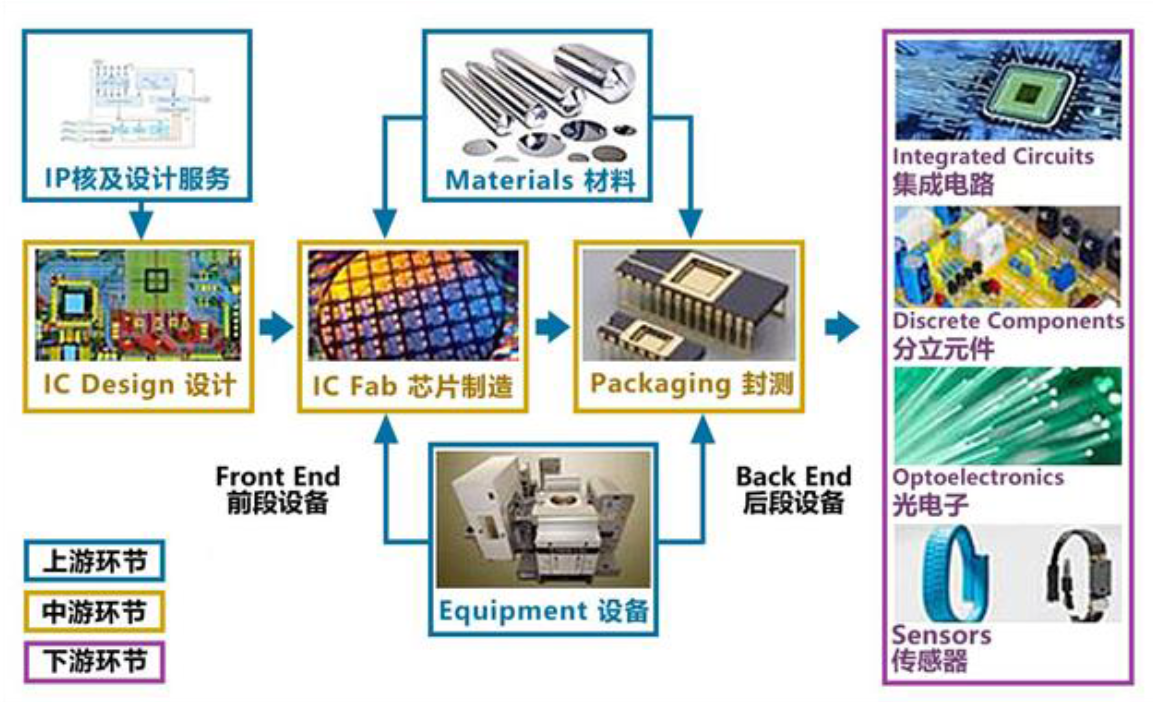
晶圆制造设备是半导体设备行业需求最大的领域,光刻、刻蚀和沉积设备为主要组成部分。根据SEMI数据来看,目前半导体设备主要为晶圆制造设备,市场占有率超过 85%。其中,刻蚀机、薄膜沉积、光刻机设备为半导体设备的核心设备,这三类半导体设备的市占率分别为22%、22%和20%。

光刻机,荷兰阿斯麦公司(ASML)横扫天下!不好意思,产量还不高,你们慢慢等着吧!无论是台积电、三星,还是英特尔,谁先买到阿斯麦的光刻机,谁就能率先具备7nm工艺。没办法,就是这么强大!日本的尼康和佳能也做光刻机,但技术远不如阿斯麦,这几年被阿斯麦打得找不到北,只能在低端市场抢份额。阿斯麦是唯一的高端光刻机生产商,每台售价至少1亿美金,2017年只生产了12台,2018年预计能产24台,这些都已经被台积电三星英特尔抢完了,2019年预测有40台,其中一台是给咱们的中芯国际。
既然这么重要,咱不能多出点钱吗?第一:英特尔有阿斯麦15%的股份,台积电有5%,三星有3%,有些时候吧,钱不是万能的。第二,美帝整了个《瓦森纳协定》,敏感技术不能卖,中国、朝鲜、伊朗、利比亚均是被限制国家。有意思的是,2009年上海微电子的90纳米光刻机研制成功(核心部件进口),2010年美帝允许90nm以上设备销售给中国,后来中国开始攻关65nm光刻机,2015年美帝允许65nm以上设备销售给中国,再后来美帝开始管不住小弟了,中芯国际才有机会去捡漏一台高端机。

重要性仅次于光刻机的刻蚀机,中国的状况要好很多,16nm刻蚀机已经量产运行,7-10nm刻蚀机也在路上了,所以美帝很贴心的解除了对中国刻蚀机的封锁。

在晶圆上完成电路图的光刻后,就要用刻蚀工艺来去除任何多余的氧化膜且只留下半导体电路图。要做到这一点需要利用液体、气体或等离子体来去除选定的多余部分。刻蚀的方法主要分为两种,取决于所使用的物质:使用特定的化学溶液进行化学反应来去除氧化膜的湿法刻蚀,以及使用气体或等离子体的干法刻蚀。
使用化学溶液去除氧化膜的湿法刻蚀具有成本低、刻蚀速度快和生产率高的优势。然而,湿法刻蚀具有各向同性的特点,即其速度在任何方向上都是相同的。这会导致掩膜(或敏感膜)与刻蚀后的氧化膜不能完全对齐,因此很难处理非常精细的电路图。
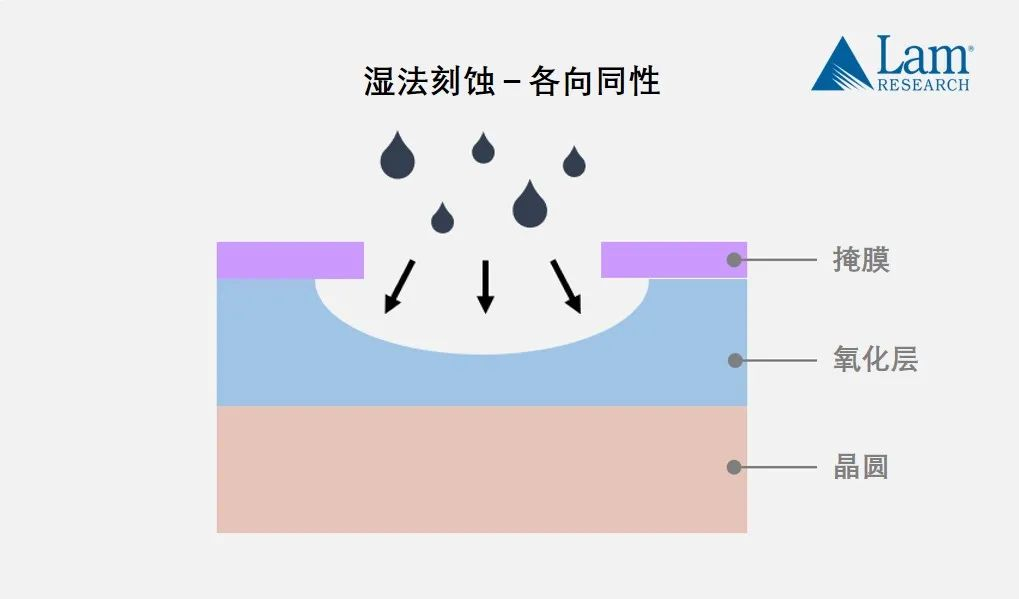
干法刻蚀可分为三种不同类型。第一种为化学刻蚀,其使用的是刻蚀气体(主要是氟化氢)。和湿法刻蚀一样,这种方法也是各向同性的,这意味着它也不适合用于精细的刻蚀。
第二种方法是物理溅射,即用等离子体中的离子来撞击并去除多余的氧化层。作为一种各向异性的刻蚀方法,溅射刻蚀在水平和垂直方向的刻蚀速度是不同的,因此它的精细度也要超过化学刻蚀。但这种方法的缺点是刻蚀速度较慢,因为它完全依赖于离子碰撞引起的物理反应。
最后的第三种方法就是反应离子刻蚀(RIE)。RIE结合了前两种方法,即在利用等离子体进行电离物理刻蚀的同时,借助等离子体活化后产生的自由基进行化学刻蚀。除了刻蚀速度超过前两种方法以外,RIE可以利用离子各向异性的特性,实现高精细度图案的刻蚀。
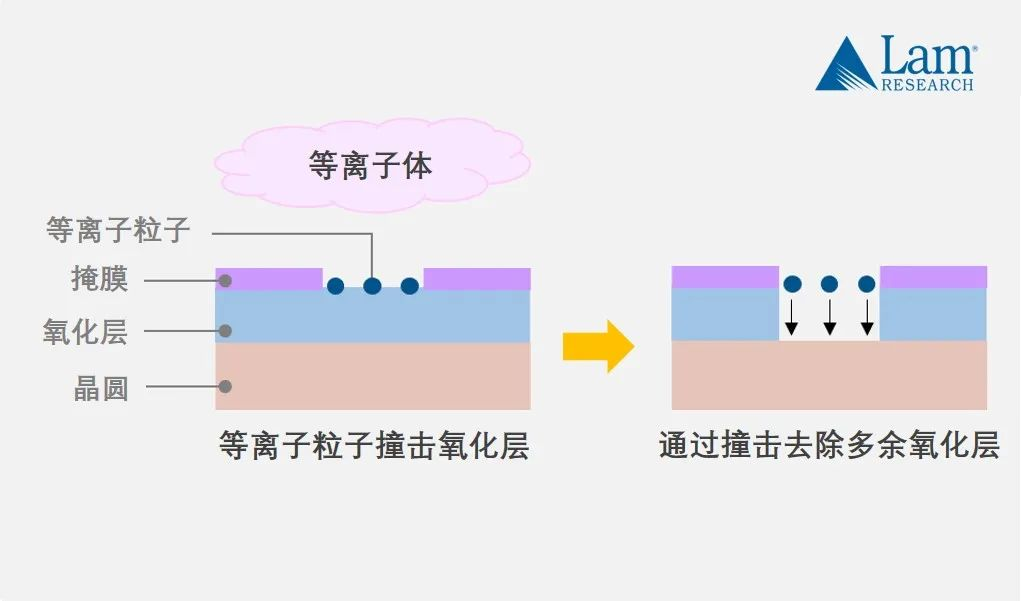
光刻是通过光线将电路图案“印刷”到晶圆上,我们可以将其理解为在晶圆表面绘制半导体制造所需的平面图。电路图案的精细度越高,成品芯片的集成度就越高,必须通过先进的光刻技术才能实现。具体来说,光刻可分为涂覆光刻胶、曝光和显影三个步骤。
① 涂覆光刻胶
在晶圆上绘制电路的第一步是在氧化层上涂覆光刻胶。光刻胶通过改变化学性质的方式让晶圆成为“相纸”。晶圆表面的光刻胶层越薄,涂覆越均匀,可以印刷的图形就越精细。这个步骤可以采用“旋涂”方法。
根据光(紫外线)反应性的区别,光刻胶可分为两种:正胶和负胶,前者在受光后会分解并消失,从而留下未受光区域的图形,而后者在受光后会聚合并让受光部分的图形显现出来。

② 曝光
在晶圆上覆盖光刻胶薄膜后,就可以通过控制光线照射来完成电路印刷,这个过程被称为“曝光”。我们可以通过曝光设备来选择性地通过光线,当光线穿过包含电路图案的掩膜时,就能将电路印制到下方涂有光刻胶薄膜的晶圆上。
在曝光过程中,印刷图案越精细,最终的芯片就能够容纳更多元件,这有助于提高生产效率并降低单个元件的成本。在这个领域,目前备受瞩目的新技术是EUV光刻。去年2月,泛林集团与战略合作伙伴ASML和imec共同研发出了一种全新的干膜光刻胶技术。该技术能通过提高分辨率(微调电路宽度的关键要素)大幅提升EUV光刻曝光工艺的生产率和良率。

③ 显影
曝光之后的步骤是在晶圆上喷涂显影剂,目的是去除图形未覆盖区域的光刻胶,从而让印刷好的电路图案显现出来。显影完成后需要通过各种测量设备和光学显微镜进行检查,确保电路图绘制的质量。
词典中的“薄膜(thin film)”是指仅靠机械加工 无法实现的在1微米(um,百万分之一米)以下 的薄膜。在晶圆上加入所需分子或原子单位薄膜 的一系列过程叫做沉积(Deposition)。由于厚度 本来就薄,为了在晶圆上均匀地形成薄膜,需要 精巧、细致的技术。
沉积的方法大致分为两种,物理气相沉积方法 (Physical Vapor Deposition, PVD)和化学气相 沉积方法(Chemical Vapor Deposition, CVD)。 物理气相沉积法主要用于金属薄膜的沉积,不会产生化学反应。化学气相沉积法是通过以蒸气态或气态的气体与外部能量发生化学反应,从而形 成沉积的方法。该技术可用于导体、绝缘体和半导体的薄膜沉积。 目前,半导体工艺主要使用的是化学气相沉积法。根据所使用的外部能量不同,化学气相沉积可分为热化学气相沉积(thermal chemical vapor deposition, TCVD),等离子体化学气相 沉积(plasma chemical vapor deposition, PCVD)和光化学气相沉积(photo chemical vapor deposition, Photo-CVD)。由于等离子体 化学气相沉积可以在低温下形成,可控制使其厚度均匀,且可大规模加工,因此被广泛使用。 通过沉积工艺形成的薄膜大致分为连接电路间 电信号的金属膜(导电)层和电气分离内部连接 层或切断污染源头的绝缘膜层。
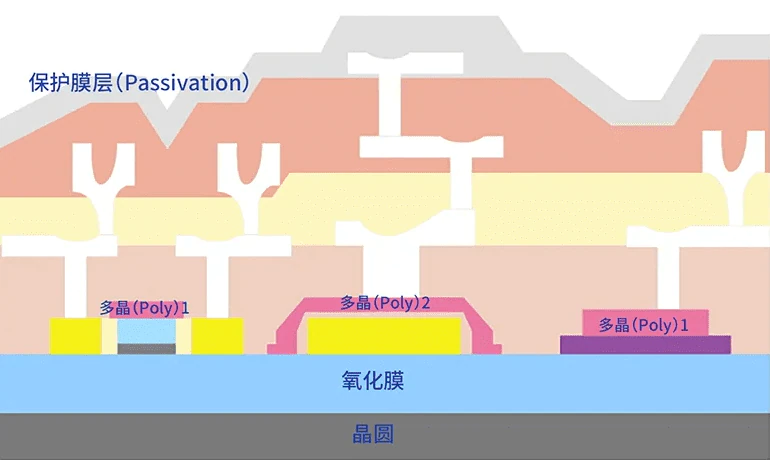
不懂缩写,你会疯的!这个行业实在是太爱缩写了!
| Introduction to AMHS system |
|---|
| AMHS: automatic material handling system |
| AGV: Automatic Guided Vehicles |
| OHS: Overhead Shuttle |
| CLL: Clean Lifer |
| MGV: Manual Guided |
| MES: Manufacture Executive System |
| PLC: Programmable Logic Controller |
| IR: infrared |
| IFIR: infrared interface |
| CCU: Central Control Unit |
| SCU: Section Control Unit |
| TFT-LCD: Thin-film Transistor Liquid Crystal Display |
| CLL: clean lifter (crane) |
| STK: stocker |
| MIF: Mechanical Interface |
| EQ: equipment |
| SPC: Statistical Process Control |
| SD: State Display |
| HUB: 网络集线器, 网络中心 |
| BCR: Bar Coder Reader |
| DI/O: Data input/output |
| OPT: optical |
| RM: Rack Master |
| RM –i/f: Rack Master Interface |
| PIO: process input/output which is guided by optical sensors |
| P&P: Pick up and Putdown |
| VTC: Vehicle Transfer Controller |
| IRIF: infrared interface, installed under ceiling of the AGV route for communication between NT7000 and AGV. |
| MIP: Local controller for mechanical and electrical parts of stocker. |
| PIO: Optical communication interface installed on the front of equipment when cassette Loading\ Unloading. |
| SCU: section control unit for overhead shuttles, which control (stop\drive)the passing by shuttle within that section. |
| CCU: central control unit for overhead shuttles, for command execution and status report. |
| MCS: module control subsystem transportation control dispatch, equipment status inventory control, transportation logging are its responsibility. |
| TCS: tool control subsystem |
| Introduction of CIM |
| CIM: Computer Integrated Manufacture |
| F A: Factory Automation |
| CFM: Center Flow Monitor It is a signal reflecting whether communication performed or not and whether it go on normally or not . |
| SPC: Statistical Process Control |
| AMS: Alarm system |
| HIS: Historical progress Data Management Historical Quality Data Management |
| EDA: Engineering Data Analysis |
| OPI: Operator Interface |
| BRM: Basic Record Management |
| PPT: Product and Process Tracking (more details offered in OPI lecture explanation) |
| SCH: Schedule Management |
| WCFM: Web Central Floor Management |
| PMS: Preventive Maintenance System |
| ALM: Alarm System |
| BC: Block Control |
| SC: Stocker Controller |
| MCS: module control subsystem transportation control dispatch, equipment status inventory control, transportation logging are its responsibility. |
| TCS: tool control subsystem |
| EQP: equipment |
| AS\RS: Automatic Storage /Retrieval System |
| CEM: Central Flow Monitor |
| PPT: product and process tracking the core of MES |
| RCM: Recipe Control and Management |
| BRM: basic record management |
| SAMP: sampling automation |
| MQC: Machine Quality Check |
| DUMY: dummy sheet for experiment |
| WIP: Work In Process, a lot of semi-manufacture material in module but not in processing. In auto mode control, MES passes message to equipment or sends the information back to MES by TCS. |
| PEWK: rework We have to redo a particular step that has leaded to the defect; or, aborting the panel is unavoidable |
| BRCH: branch route. With the purpose of reinforcing the flexibility, we can adjust our product line timely to whet our customer’s appetites. Setting is like a REWK route, but it is not rework. The product line turn to branch route when the lot’s parameter name\value is as same as equipment’s parameter name\value. It means Condition of branch |
| CRCL: cleaning route for carrier |
| EQTR: Equipment Transition Type |
| DUMY: route for dummy sheet |
| WIP: working in process |
| QRS: Q-Restriction, it has two types. One is Maximum Q-Time; he other is Minimum Q-time; meanwhile, QRS Operation should be processed between them. |
| EC CODE: Engineering Change Code |
| BCS Node: |
| EQRM: Equipment Run Mode |
| EQAR: Equipment Area Code |
| STB:P6 |
| OPI lecture explanation |
| MCS: module control subsystem transportation control dispatch, equipment status inventory control, transportation logging are its |
| responsibility. |
| OPI: operation interface (more details offered in OPI lecture explanation) |
| PPT: Product and Process Tracking (more details offered in OPI lecture explanation) |
| TCS: Tool Control Subsystem In auto mode control, MES passes message to equipment or sends the information back to MES by TCS. |
| REWK: rework We have to redo a particular step that has leaded to the defect; or ,aborting the panel is unavoidable |
| BRCH: branch route. With the purpose of reinforcing the flexibility, we can adjust our product line timely to whet our customer’s appetites. Setting is like a REWK route, but it is not rework. The product line turn to branch route when the lot’s parameter name\value is as same as equipment’s parameter name\value. It means Condition of branch. |
| OPER: operation |
| DEPT: department |
| MQC: machine quality check route. This route is used for only MQC Lot. |
| TCS: tool control subsystem |
| PPT: product and process tracking |
| BR: Basic Record |
| The Common Specification of Equipment Automation for TFT |
| TFT: Thin-Film Transistor |
| CIM: Computer Integrated Manufacture |
| LDRQ: load request |
| LDCM: load complete |
| UDRQ: unload request |
| UDCM: unload complete |
| DOWN: equipment is disable |
| SECS: the communication protocol at TFT shop |
| HSMS: message protocol |
| MSB: most significant byte |
| LSB: least significant byte |
| LOT STATE DEFINITIONS: |
| PROC: processing |
| PREN: process end |
| ABND: abnormal end |
| ABOT: abort end |
| CAEN: cancel end |
| S1F1: S: stream F: function |
| CONTRACT SPECIFICARACT (cell) |
| DFK: DAIFUKU 日本大福公司 |
| BCR: Bar Coder Reader |
| T.B.D: to be determined |
| Electrical Power: AC208V±10% 3P 3W E3 GPS\ EPS |
| GPS: General Power Supply |
| EPS: Emergency Power Supply |
| UPS: Uninterruptible Power supply |
| CLS: Clean Liter System |
| R\M: Rack Master |
| CLL: CLean Lifter |
| CSC: one part of OHS |
| spot Mg: spot magnet |
| SS Radio: Spread Spectrum Radio 展布频谱 |
| MIF: Mechanical Interface |
| LED: Low Emitting Diode, 发光二极管 |
| ODT: Optical Data Transmit |
| MCP7 Master Control Processor number seven |
| MES: Manufacture Executive System |
| MCP: Master Control Processor |
| MCS: Module Control System It bears the responsibility for transportation command dispatch, equipment status Inventory control, transportation logging. |
| BCR: Bar Coder Reader |
| RM –i/f: Rack Master Interface |
| E23: Semi Standard Code |
| SD: Status Display |
| VGC: Vehicle Ground Controller |
| VTC: Vehicle Transfer Controller |
| MCP: Master Control Processor |
| EMS: EMergence Stop |
| R\M: Rack Master |
| NG: NotGood |
| Conv: MGV/AGV I/O Conveyor |
| TFE: Transfer Equipment |
| GUI: Graphic User Interface 图形用户界面 |
| MCBF: Mean Cycle Between Failure |
| DIO: Digital Input/ Output |
| OS: Operation System |
| EMO: Emergence Off When any EMO is pressed, power to the related device is shut down and the device will be stopped. |
| HP: Home Position |
| OP: Opposite Position |
| LAN: 局域網 |
| HDD: Hard Disk |
| FDD: Floppy Disk |
| PCI: Peripheral Component Interconnect 一種接口 |
| FFU: one kind of aerial dust filter |
| KVA: 1000 voltages multiples ampere . It is a unit of Power. |
| GPS: General Power Supply |
| EPS: Emergency Power Supply |
| HID: High Efficiency Inductive Power Distribution |
| MCP: Master Control Processor |
| AP: Access Point |
| Spot Mg: Spot Magnet |
| LFT: Lifter |
| M/L: Maintenance Lifter |
| OHS: Overhead Hoist System |
| -C: controller |
| DC: 直流電源 |
| 其他 |
| TCS:Tool Control System |
| BC:Block Control |
| DCS:Dispatch Control System |
| MCS:Material Control System |
| FA:Factury Automation |
| AS:Automatic Storage |
| RS:Retrieval System |
| EWS:Engineering Workstation Sever |
| SCH: |
| HIS:History |
| OCAP:Out of Control Action Plan,失控行动计划 |
| CST:cassette |
| TAT:Turn Around Time |
| 缩写 | 全称 | 描述 |
|---|---|---|
| BMT | Block Mouting | 粘棒 |
| WSW | Wire Saw | 线切 |
| SWC | Sliced Wafer Cleaning | 脱胶后清洗 |
| SOE | Sliced Orientation Evaluation | 晶向检测 |
| SWE | Sliced Wafer Evaluation | 平坦度检测 |
| 4PP | Four Point | 四探针检测 |
| EDG | Edge Grinding | 倒角 |
| EDE | Edge Grinding Profile Evaluation | 倒角轮廓检测 |
| LAP | Lapping | 磨片 |
| LWE | Lapping Wafer Evaluation | 磨片后检测 |
| HLM | Hard Laser Evaluation | 打标 |
| CAE | Caustic Etching | 碱腐 |
| CEE | Caustic Etching Evaluation | 碱腐后检测 |
| DSP | Double side polishing | 双抛 |
| DPC | Double side polishing cleaning | 双抛后清洗 |
| DWE | DSP Wafer Evaluation | 双抛后检测 |
| EPC | Edge Polishing Wafer Cleaning | 边抛后清洗 |
| CMP | Final Polishing | 最终抛光 |
| CME | Partical Evaluation After CMP | 终抛后颗粒检测 |
| WFI | Wafer Inspection | 终抛后目检仪检测 |
| FNC | Final Cleaning | 最终清洗 |
| EPE | EPI Partical Evaluation(Pre) | 外延前颗粒检测 |
| PKG | Packaging | 包装 |
Copyright © 2002-2024 PP电子·(中国)官方网站 版权所有 非商用版本 备案号:苏ICP备20035126号-1